构成物质的基本单位是原子,纳米技术的出现意味着人类将在原子层上认识未知世界。这个研究小组还成功地合成出世界上最长的碳纳米管,创造了“3毫米的世界之最”。......
2024-07-20
目前,能够进行纳米测量的方法主要有光学方法和非光学方法两大类。光学方法主要包括X射线干涉法、各种形式的激光干涉法和光栅测量法;非光学方法包括SPM法、电容、电感测微法等(见图2-1)。
扫描探针(SPM)法是指利用各种扫描探针显微镜的原理进行长度测量的方法。SPM是利用探针与样品之间的相互作用来探测物质表面相关特性的一类仪器,主要包括扫描隧道显微镜(STM)、原子力显微镜(AFM)扫描力显微镜(SFM)等等,它们的原理及应用将在第三章进行详细阐述。扫描探针显微镜的应用,实现了原子尺度上物质结构的直接观测和原子操纵。但是,它们在计量学上的应用才刚刚起步,它们虽然具有纳米级甚至亚纳米级的分辨率,但不能达到同等量级的测量精度。因为扫描器PZT的误差、探针(或样品)的热漂移等都会严重影响SPM测量和定位的精度。
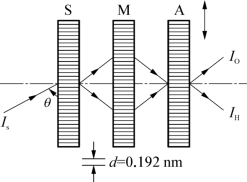
电容、电感测微法的基本原理是将位移变化转换为电容或电感的电信号变化,通过测量电信号的变化实现位移的间接测量,适用于相对位移的测量。它们的优点是分辨率高(可达到1 nm),精度可达到几个纳米,简单易用,成本比较低。但是量程都比较小,一般为几十到几百微米不等,因此应用场合受到限制[1,2]。
X射线干涉法最初由Hart等人在1968年提出,是利用间隔为0.192 nm、稳定性为10-8的单晶硅晶格作为标尺实现位移测量。它的基本原理如图2-1所示,由分束器S、镜像器M和分析器A构成的,三者相互平行且用同一单晶硅晶片基体制作。X射线以Bragg角θ入射晶格。若d为晶格间距,λ为波长,则有
![]()
当分析器A相对于其他两块晶体移动时,输出光的强度会按正弦规律周期性变化,且分析器A每移动一个晶格间距,输出光强变化一个周期。经过条纹细分后,很容易实现纳米精度位移测量。X射线干涉法的测量分辨率可达0.005 nm,测量精度可达0.01 nm,测量范围为200μm[3]。
X射线干涉法的缺点是单晶硅的选择加工困难,量程小,测量速度慢,而且由于弹性变形和机械加工等因素引入的测量误差很大,从而在很大程度上限制了它的应用。
激光干涉仪[4-9]是以激光波长作为长度基准对数控设备(加工中心、三坐标测量机等)的位置精度(定位精度、重复定位精度等)、几何精度(俯仰扭摆角度、直线度、垂直度等)进行精密测量的系统。该系统不仅能测量线位移和线速度,还可以测量角度及各种形变误差等几何量[10]。自从He-Ne激光器问世以来,激光干涉仪以其特有的大量程、高分辨率和高测量精度等优点,在精密和超精密位移测量领域得到了广泛的应用。
激光干涉仪可分为零差(单频)干涉仪和外差(双频)干涉仪。与零差干涉仪相比,外差干涉仪具有抗干扰能力强,稳定性高、对光强波动不敏感、响应速度快、信噪比高以及多通道测量中交流放大器具有高增益等优点,易于实现高精度和高分辨率,因此被广泛应用于纳米测量系统中[11]。
外差干涉仪是基于迈克尔逊干涉仪的基础,使用频差在几兆到几千兆赫兹的两个不同频率的光波作为干涉仪的光源。它的基本原理是将被测位移量引入到外差信号的频率或者相位变化中,再将这种变化测量出来。由于外差信号的频率比光频低得多,光电信号经电子细分后,可以得到很高的测量精度和分辨率。如美国国家标准技术局研制的“分子测量机”和“校准式原子力显微镜”中均采用了激光外差式干涉仪,其精度为0.1 nm。
光栅测量法是以光栅栅距为测量基准,测量精度主要取决于光栅栅线的刻制精度,受光源光强和波长变化的影响较小,因此具有较好的测量精度和稳定性。目前,光栅式测长仪器的分辨率可达纳米量级,量程可达上百毫米,已达到了相当高的水平。例如德国海德汉(HEIDENHAIN)公司的LIP382型敞开式直线编码器,由两块高线数(500~2 000 l/mm)的光栅形成光栅付,通过一定的光路产生微米级或者亚微米级的光学莫尔条纹,再配以几百倍的电子细分来实现纳米级的测量分辨率。全息光栅测长系统是通过两束单色平行光干涉的原理制成的,每毫米可以做到6 000线甚至更高,也可以实现纳米级的测量分辨率[12-15]。
表2-1列出了几种可实现纳米分辨率的测量仪器或方法,可以看出,在纳米分辨率的情况下,前7类仪器仅可用于小量程(<mm)的精密位移测量,其中,扫描显微镜主要用于原子级的物体表面形貌分析,只有激光干涉仪和光栅测量法是毫米以上量程的两种主要精密测量手段。但为了能更好地用于实际测量,这两种纳米级测长系统也常与其他设备配合使用,如用于机床上进行精密定位和测量等,而不是单独使用,因此在此书中只对其测试手段进行简单涉及,而不详细阐述,如有兴趣,可查阅相关文献或参考书目。
表2-1 几种纳米级分辨率测试仪器方法比较

有关纳米材料与结构测试方法的文章

构成物质的基本单位是原子,纳米技术的出现意味着人类将在原子层上认识未知世界。这个研究小组还成功地合成出世界上最长的碳纳米管,创造了“3毫米的世界之最”。......
2024-07-20

渠道测量和管道测量在勘测设计阶段的主要测量内容有踏勘、选线、中线测量、纵横断面测量以及相关的工程调查工作等。在施工管理阶段,需进行施工测量。施工测量应按设计和施工的要求,测设中线和高程的位置,以作为工程细部测量的依据。施工测量的精度应以满足设计和施工要求为准。渠道和管道的开挖是否经济合理,关键在于中线的选择。......
2023-06-29

表1-1单位换算进制2.纳米材料的定义材料是指可以用来制造有用的构件、器件或物品的物质。所谓纳米材料,是指在一维、二维或三维的空间始终处于1~100 nm范围内的晶体或非晶体。实际上,纳米材料的尺度划分并不是很严格。在考虑其是否属于纳米材料时有两点要考虑具体如下。二是纳米结构材料。在当时的条件下,人们并不知道纳米材料的概念,更没有手段去研究、分析这些材料。......
2023-06-20

纳米材料中有一类重要的存在形式——薄膜纳米材料。对于这类材料,X射线衍射除了可以对其进行物相分析和晶粒尺寸的研究外,还可测定薄膜的厚度。Anderson和Thomson成功地利用这种方法测定了Ni和ZrO2膜的厚度。这种方法能用于非晶和晶体样品,但要求整个研究范围内的薄膜厚度均一。......
2023-06-20

测出两侧线路转角杆至相邻两杆的距离,记入施工测量手册。2)进行杆根定位,中心桩向角平分线的两侧各测量1/2AB根开距离,就是两杆的杆位桩。测量时,将经纬仪架在转角杆中心桩上,前后视相邻杆中心桩,水平度盘指零。根据转角度数测出角平分线和其直线,再钉四个辅助桩,就可根据直线塔测定坑位法,测出铁塔四脚坑位,如图249所示。图249转角塔中心位移定位图2410不等高塔位不等高塔脚的测量。......
2023-06-29

科学技术上的重大成就往往是以测量仪器和方法的突破为先导的。同样,其他纳米材料性能的测量、分析/表征技术也是纳米材料研究和应用中必不可缺的重要部分。纳米测量,是指对纳米材料的成分、结构、尺寸、形状、微观形貌、缺陷及其各种性能的表征技术,以及相关的理论基础的科学。根据所采用的测量信号不同,可将纳米测量技术分为不同的种类,但总体而言,都是利用对所表征的纳米材料的物理或化学性质参数及其变化来实现的。......
2023-06-20

(一)理性分子设计从蛋白质工程的发展历史来看,早期蛋白质工程的技术就是基因定位突变。图4-1蛋白质理性分子设计流程图第二,从天然蛋白质的三维结构出发,利用计算机模拟技术确定突变位点及替换的氨基酸。目前常用的定位突变方法主要有寡核苷酸引物介导的定位突变,重组PCR介导的定位突变及盒式突变等。重组PCR介导的定位突变优点是操作较简单,突变的成功率可达100%。......
2023-11-18
相关推荐