在9.4.1节和9.4.2节中,利用标记物的移动实验显示了电迁移在SnAg3.8 Cu0.7中比在共晶锡铅中慢得多。对于迁移率项,扩散率的差异会非常大;共晶锡铅焊料的扩散率可能会比共晶锡银铜大一个数量级。同时,较小的晶粒尺寸和锡铅焊料上形成的共晶片状界面可能导致扩散率增大。因此,在共晶锡铅焊料中的电迁移会更快。值得一提的是,锡铅倒装芯片焊点在高温下的电迁移存在一个很大的锡原子的反向扩散通量。该内容将在9.5节和9.7节进行讨论。......
2023-06-20
图9.11所示为无铅焊料凸点第一横截面,图9.11(a)~(d)分别是在电迁移试验前,与实验20 h、110 h、200 h之后的情况,温度为120℃,实验电流大小为1.5 A。电子流动方向为从镍UBM层到铜凸点焊盘。实验200 h后,在阴极有孔洞生成[图9.11(d)]。其孔洞形成过程比在9.4.1节中我们讨论过的共晶锡铅焊料要慢得多。但是,在阳极的金属间化合物被挤压成了小丘状。相比之下,共晶锡铅焊料在电迁移过程中,没有化合物被挤压出来。
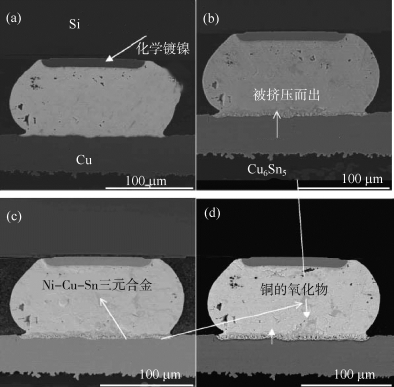
图9.11 无铅焊料凸点第一横截面
(a)实验前;(b)实验20 h后;(c)实验110 h后;(d)实验200 h后
图9.12所示为标记物a和标记物b在横截面上的运动。其标记物移动量远少于共晶锡铅焊料中的标记物的移动量。在焊料底部区域的标记物移动量更多(4号和5号标记物),它们比较接近被挤压出的金属间化合物。然而,接近化学镀镍UBM层的编号为1号~3号的标记物移动量很小。和共晶锡铅焊料相比,标记物在SnAg3.8 Cu0.7中的移动量要小得多,这表明后者的电迁移过程进行得比前者慢。
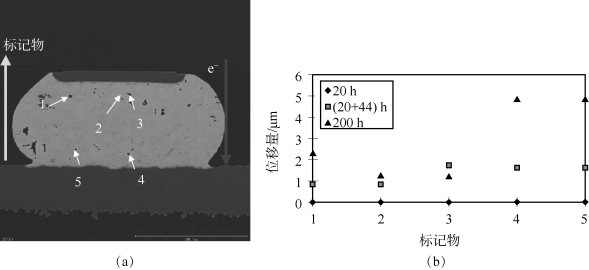
图9.12 标记物位置及位移量
(a)标记物位置;(b)标记物在无铅焊料焊点的一个横截面表面的移动量
样品在垂直于第一横截面的方向进行了第二次横切,图9.13所示为其SEM照片。在阴极处可以观察到孔洞的形成和镍基UBM层的溶解。然而,第一横截面显得很平坦,没有出现明显的凹陷或鼓包。在焊料基体中发现了镍铜锡三元合金化合物(在显微图中颜色较深),这一点与共晶锡铅焊料类似。在电迁移的过程中,该合金生长并穿透了焊料凸点的整个横截面。距化学镀镍UBM层最远的合金,其距离为90μm,几乎到达了铜的阳极处。
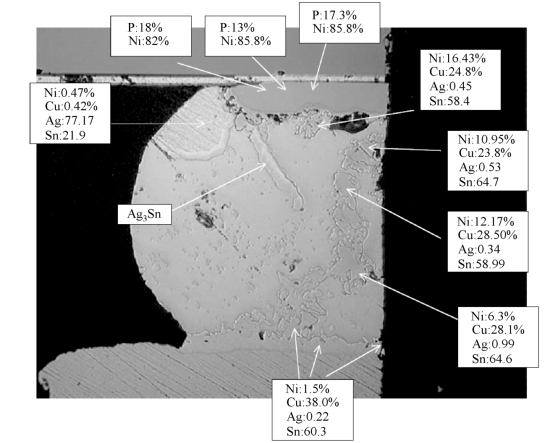
图9.13 无铅焊料焊点的第二横截面的SEM照片
(图中分数均为原子百分数)
有关电子软钎焊连接技术 材料、性能及可靠性的文章

在9.4.1节和9.4.2节中,利用标记物的移动实验显示了电迁移在SnAg3.8 Cu0.7中比在共晶锡铅中慢得多。对于迁移率项,扩散率的差异会非常大;共晶锡铅焊料的扩散率可能会比共晶锡银铜大一个数量级。同时,较小的晶粒尺寸和锡铅焊料上形成的共晶片状界面可能导致扩散率增大。因此,在共晶锡铅焊料中的电迁移会更快。值得一提的是,锡铅倒装芯片焊点在高温下的电迁移存在一个很大的锡原子的反向扩散通量。该内容将在9.5节和9.7节进行讨论。......
2023-06-20

在20~40 h的电迁移之后,第一横截面的共晶锡铅焊料表面上,能观察到阳极的铅的聚集和阴极的孔洞的形成。图9.10所示为同时具有焊料凸点的第一横截面的第二横截面。因此,上面的Z*计算可能是不精确的,结果只是指出共晶锡铅焊点中电迁移的大致趋势。......
2023-06-20

我们测试两种焊料凸点并比较它们的电迁移现象。第一次回流在把焊料凸点印刷在芯片上后完成,第二次回流是为了组装芯片和印刷线路板。为了对焊料凸点电迁移进行实时观测,在电迁移测试之前,我们采用机械和化学方法将一对焊料凸点切为截面并抛光。为了可以进行观察,要时常暂停电迁移试验,所以观察是不连续的且在不同的时间下重复进行的。图9.8观察电迁移时所用倒装芯片焊点两个横截面的原理......
2023-06-20

图9.2焊点电流分布焊点电流分布二维仿真示意;焊点电流分布三维示意图9.3所示为倒装芯片焊点中电迁移损伤的一组SEM照片。由于孔洞的形成只能发生在硅晶片与阴极的接触一侧,也就是电子流入焊点的地方,所以说倒装芯片焊接中的电迁移失效模式是很独特的。......
2023-06-20

直流电迁移中存在着极化效应。然而我们需要考虑的是电迁移过程中热迁移的贡献。当电迁移产生的焦耳热在焊料接头上引起了1 000℃/cm的温度梯度时就会出现热迁移。若假设硅芯片侧的温度较高,热迁移就会驱使主要扩散元素向下运动,其方向与下移电子引起的电迁移相同,因此电迁移和热迁移效应会累加。然而在右侧的凸点中,电迁移会使原子向与热迁移相反的方向运动,即这两种迁移效果互相抵消。......
2023-06-20

用于热迁移测试的共晶37Pb63Sn倒装芯片焊料接头的测试结构与图12.2很相似,其有11个凸点。而通电凸点附近的未通电的凸点将用来研究热迁移。图12.7所示为四个未通电的凸点在电迁移测试后的横截面SEM照片。图12.7四个未通电的凸点在电迁移测试后的横截面SEM照片图12.8所示为未通电凸点的横截面高倍照片,图中Sn和Pb的重新分配表现在:铅大量积累在了冷端(基板端),热端处(芯片端)没有锡积累。......
2023-06-20

焦耳热不仅会增加焊料凸点的温度,从而增加电迁移速率,还可能在焊料凸点上产生小的温度差,从而导致热迁移。热迁移将在第12章中讨论。焊料接头中另一个非常独特和重要的电迁移行为是它有两个反应界面。图1.16所示为阴极接触界面处电迁移导致的失效的SEM横截面照片,其中额定电流密度约为2×104 A/cm2,试验温度为100℃。图1.16一组由倒装芯片焊料接头阴极处的电流拥挤造成的14μm厚的金属Cu的UBM层溶解导致的电迁移失效SEM照片......
2023-06-20

每根焊丝每小时熔敷金属量11~20kg,焊丝直径一般为3.2mm。丝极电渣焊适合于焊缝较长的工件及环焊缝的焊接。熔嘴电渣焊可用于焊接比板极电渣焊更大断面的工件,并且适用焊接不规则断面的工件。熔嘴电渣焊所用设备也比较简单,焊丝的送进用一般送丝机构即可。......
2023-06-26
相关推荐